
Микроэлектромеханические системы (МЭМС) как правило являются хрупкими приборами и часто содержат движущиеся части, которые могут быть повреждены при разделении пластин. Корпусирование на уровне пластины (Wafer level packaging, WLP) перед разделением может предотвратить повреждение, а также загрязнение частицами и суспензией при резке, в то же время позволяя значительно уменьшить размеры и стоимость приборов.
Многие МЭМС, такие как микродатчики, должны эксплуатироваться в вакууме или контролируемой атмосфере. Это требование может быть обусловлено необходимостью стабилизации определенных характеристик, например добротности (Q-фактора), опорного давления (вакуума) в датчиках абсолютного давления, или уменьшения поглощения в инфракрасных датчиках с целью повышения их чувствительности и разрешения. Примерами корпусирования на уровне пластины являются технологии соединения двух кремниевых пластин и тонкопленочная инкапсуляция, каждая из которых имеет определенные преимущества для конкретных областей применения.
СОЕДИНЕНИЕ ДВУХ ПЛАСТИН
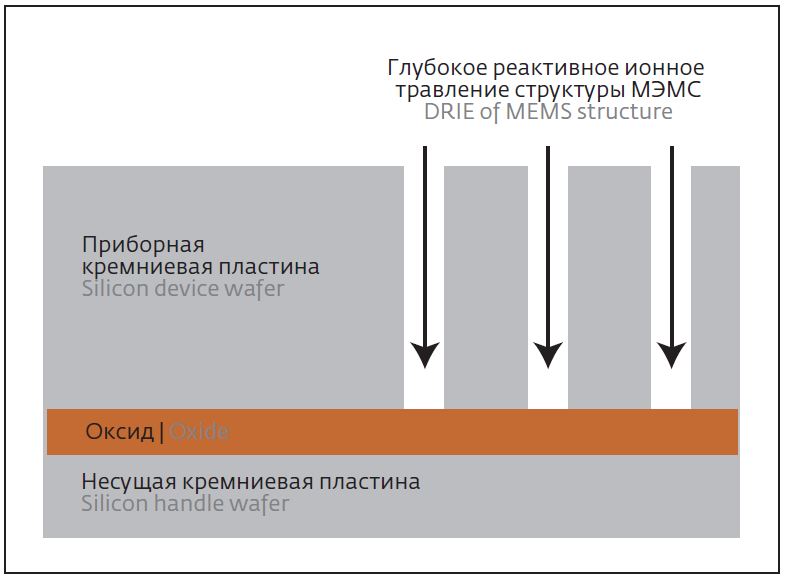
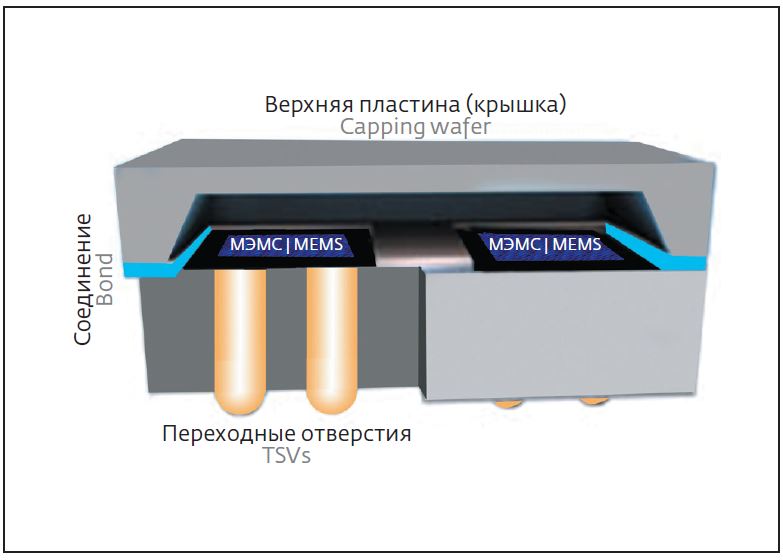
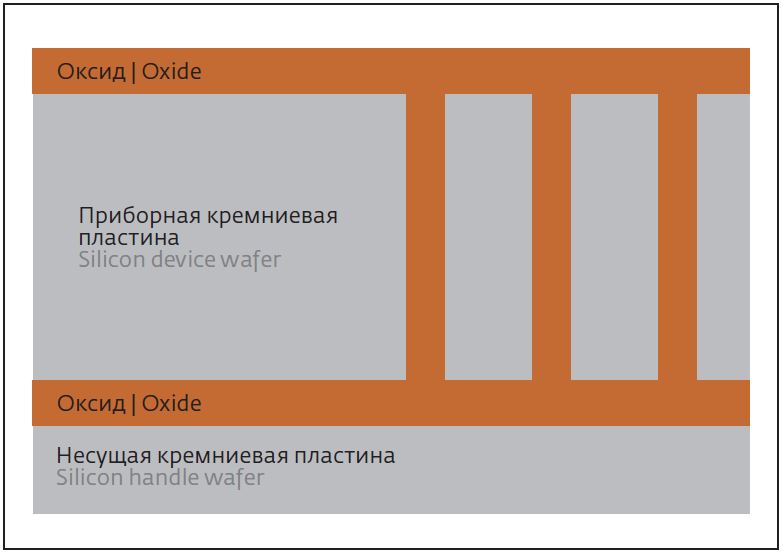
Одним из распространенных способов корпусирования МЭМС является соединение двух кремниевых пластин, на одной из которых располагаются функциональные структуры, а другая выполняет роль крышки (рис.1). Такое решение позволяет размещать несколько датчиков на одном кристалле, применяя эвтектические припои при меньшей площади соединения, чем в случае традиционных стеклокерамических припоев. Вместо контактных площадок ввода-вывода можно использовать переходные отверстия в кремнии TSV (through-silicon via), что обеспечит дополнительное уменьшение размеров.
ТОНКОПЛЕНОЧНАЯ ИНКАПСУЛЯЦИЯ
Более дешевая и простая альтернатива – инкапсуляция тонкой пленкой. Благодаря исключению необходимости герметизации и приклеивания пластины-крышки, тонкопленочная инкапсуляция является для некоторых конструкций МЭМС самым технологичным и дешевым решением. В этом методе используется двойной жертвенный слой (обычно из кремния или оксида кремния), который служит временной опорой структуры МЭМС и заполняет свободное пространство, в то время как слой, формирующий “крышку”, осаждается поверх структуры прибора (рис.2 и 3). Через отверстия в верхнем слое травящий агент (например, пар HF или XeF2, в зависимости от материала жертвенного слоя) удаляет жертвенный слой и «освобождает» подвижные элементы МЭМС (рис.4 и 5). Затем отверстия закрываются герметизирующим слоем из поликристаллического кремния (эпитаксия или LPCVD), оксида кремния SiOx (PECVD), нитрида кремния SiNy или металлов, например, алюминия (рис.6).
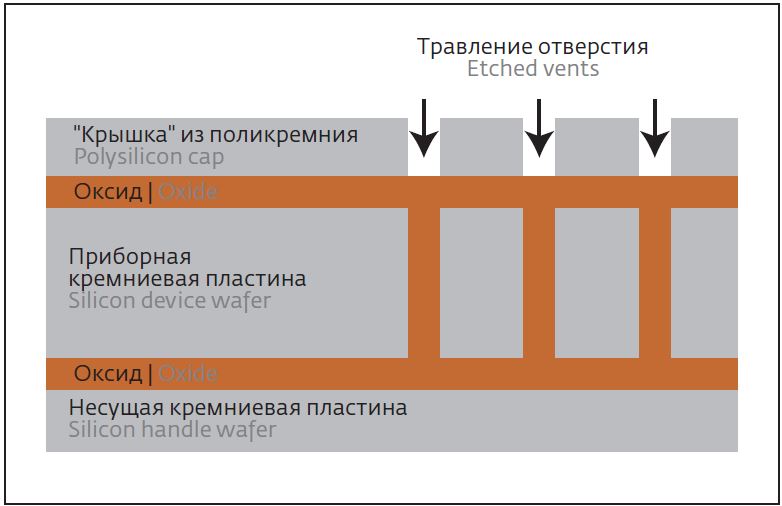
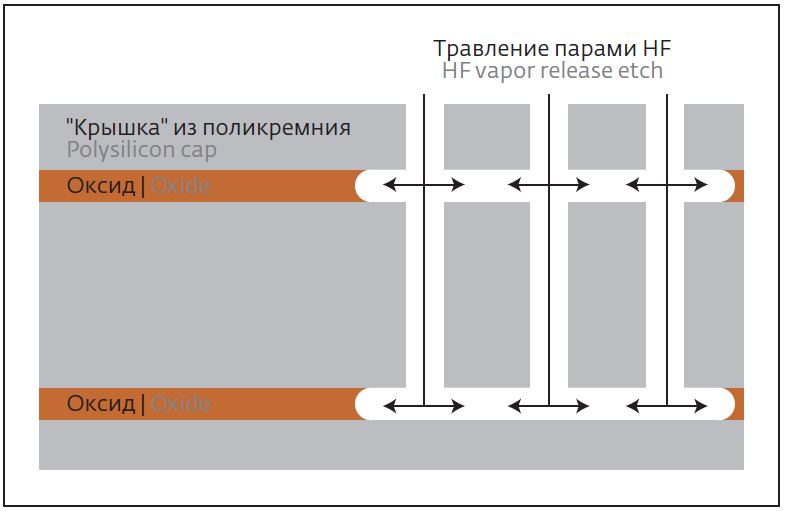
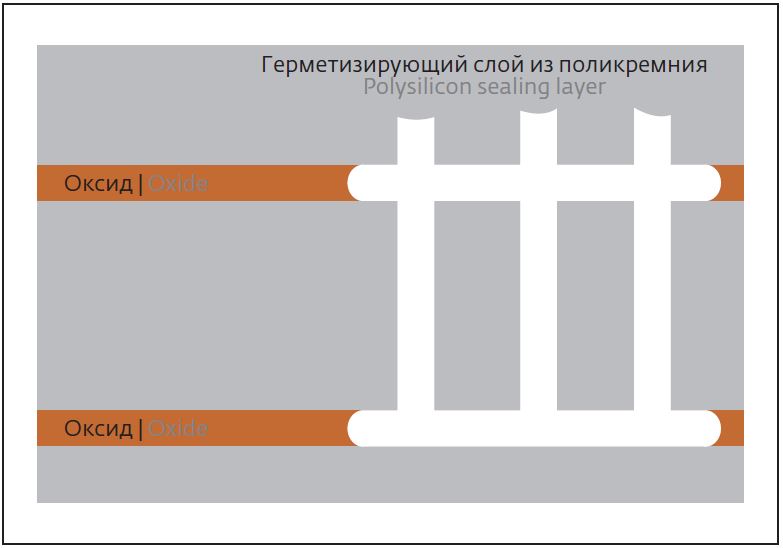

ПРАКТИЧЕСКОЕ КОРПУСИРОВАНИЕ МЭМС НА УРОВНЕ ПЛАСТИНЫ С ИСПОЛЬЗОВАНИЕМ ТОНКОПЛЕНОЧНОЙ ИНКАПСУЛЯЦИИ
В идеальном случае между травлением и нанесением герметизирующего слоя пластина должна постоянно находиться под вакуумом, чтобы избежать снижения качества и производительности из-за нежелательной абсорбции загрязняющих газов или влаги. Различным МЭМС- устройствам требуется разное давление в полости прибора, и требуемые состав газа и величину давления можно настроить до герметизации.
Выбор герметизирующего материала определяется требованиями к прочности, температурной стойкости и уровню вакуума (рис.7–8).
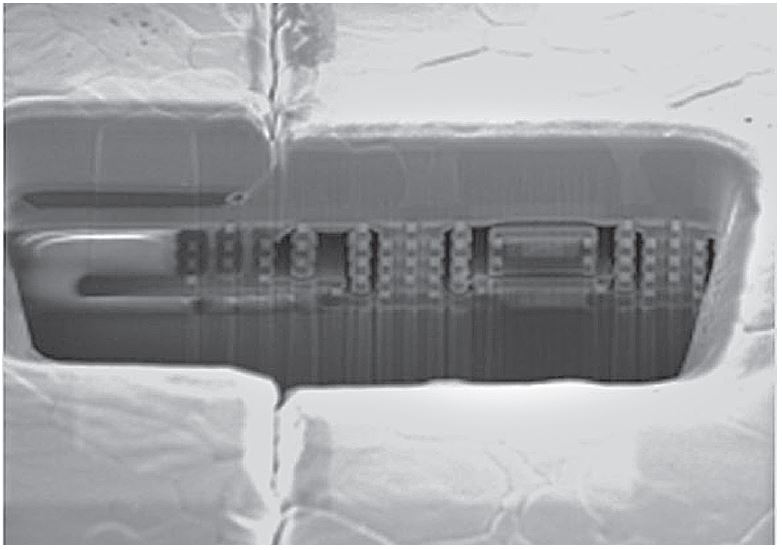
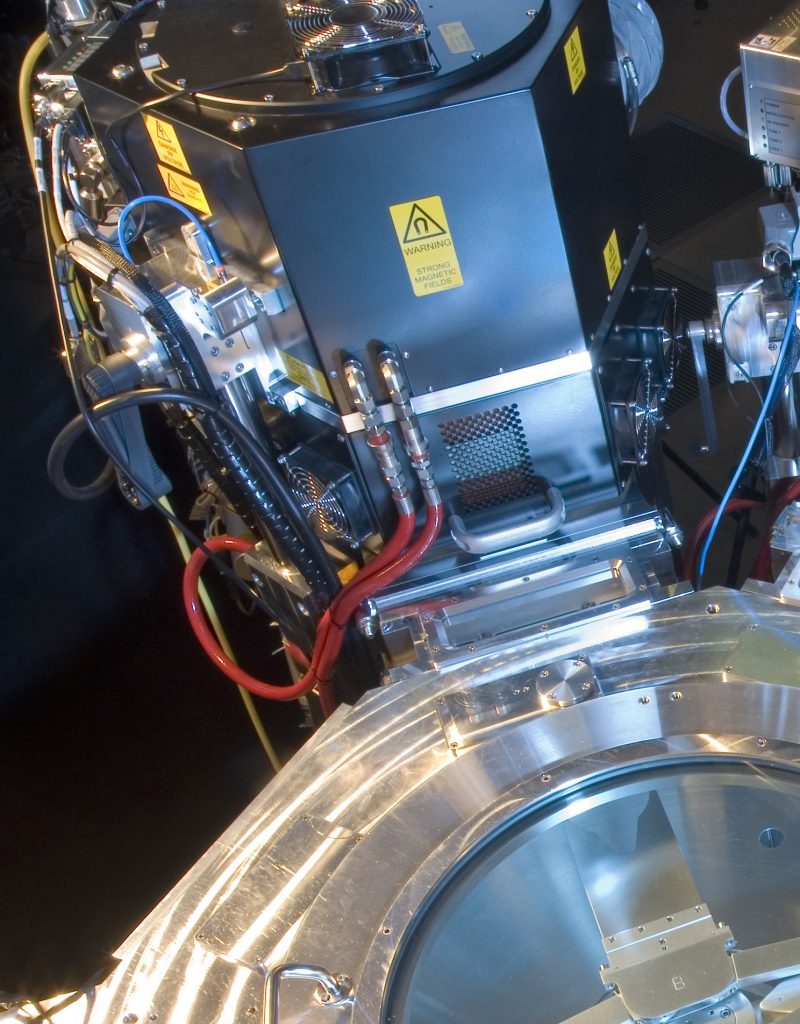
SPTS обладает следующими уникальными компетенциями в области решений для тонкопленочной инкапсуляции:
• технологическое лидерство в сфере глубокого реактивного ионного травления (Deep reactiveion etching, DRIE) (рис.9) для формирования структуры МЭМС и переходных отверстий с высоким аспектным отношением и малым наклоном. Уникальная система контроля Claritas;
• низкотемпературная технология PECVD, совместимая с чувствительными к температуре устройствами МЭМС;
• травление парами HF или XeF2 может быть интегрировано в проверенные промышленные кластерные системы (рис.10);
• пакетная обработка пластин в системах LPCVD обеспечивает экономически эффективное осаждение толстых слоев поликристаллического кремния и диэлектриков, в случаях, когда допустимы высокотемпературные процессы;
• платформа Versalis fxP (рис.11) позволяет интегрировать различные процессы в единой кластерной системе для минимизации эксплуатационных затрат.

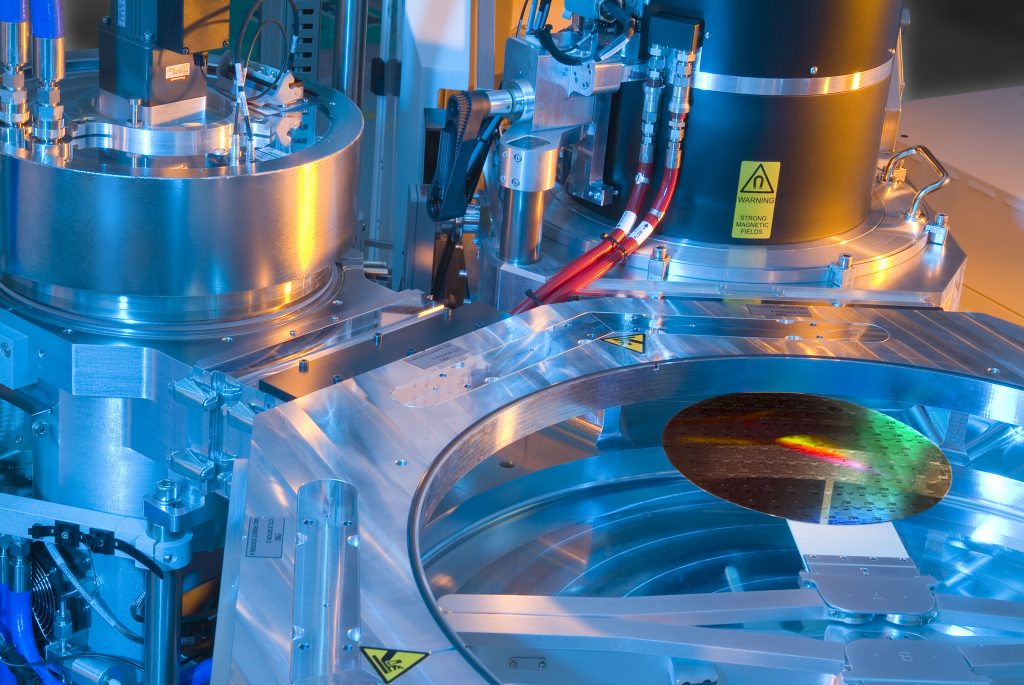
Журнал «Наноиндустрия». Выпуск #3-4/2018(82)